
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
अर्धचालक प्रशोधन मा ओक्सीकरण
अर्धचालक निर्माणमा, धेरै प्रतिक्रियाशील रसायनहरू विभिन्न प्रक्रियाहरूमा संलग्न हुन्छन्। यी पदार्थहरूको अन्तरक्रियाले सर्ट सर्किट जस्ता समस्याहरू निम्त्याउन सक्छ, विशेष गरी जब तिनीहरू एकअर्कासँग सम्पर्कमा आउँछन्। ओक्साइडेशन प्रक्रियाहरूले वेफरमा सुरक्षात्मक तह बनाएर त्यस्ता समस्याहरूलाई रोक्न महत्त्वपूर्ण भूमिका खेल्छ, जसलाई अक्साइड तह भनिन्छ, जसले विभिन्न रसायनहरू बीचको अवरोधको रूपमा काम गर्दछ।
ओक्सीकरणको प्राथमिक लक्ष्यहरू मध्ये एक वेफरको सतहमा सिलिकन डाइअक्साइड (SiO2) को तह बनाउनु हो। यो SiO2 तह, जसलाई प्राय: गिलास फिल्म भनिन्छ, अत्यधिक स्थिर र अन्य रसायनहरू द्वारा प्रवेश गर्न प्रतिरोधी छ। यसले सर्किटहरू बीचको विद्युतीय प्रवाहलाई पनि रोक्छ, सेमीकन्डक्टर उपकरणले ठीकसँग कार्य गर्दछ भनेर सुनिश्चित गर्दछ। उदाहरणका लागि, MOSFETs (मेटल-अक्साइड-सेमिकन्डक्टर फिल्ड-इफेक्ट ट्रान्जिस्टरहरू) मा, गेट र हालको च्यानललाई गेट अक्साइड भनिने पातलो अक्साइड तहद्वारा अलग गरिएको छ। यो अक्साइड तह गेट र च्यानल बीच प्रत्यक्ष सम्पर्क बिना प्रवाह को प्रवाह नियन्त्रण गर्न को लागी आवश्यक छ।
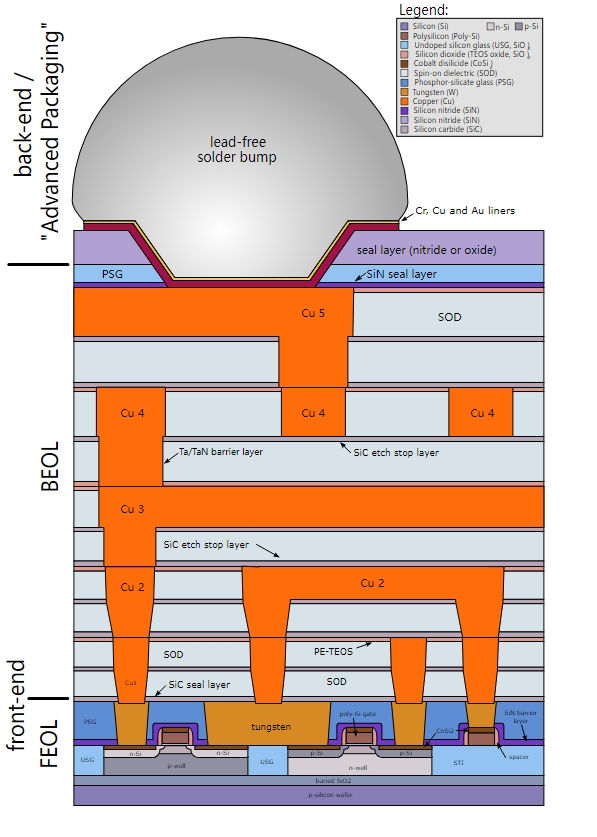
अर्धचालक प्रक्रिया अनुक्रम
ओक्सीकरण प्रक्रिया को प्रकार
गीला ओक्सीकरण
भिजेको ओक्सीकरणले वेफरलाई उच्च-तापमान स्टीम (H2O) मा पर्दाफास गर्ने समावेश गर्दछ। यो विधि यसको द्रुत ओक्सीकरण दर द्वारा विशेषता हो, यो अनुप्रयोगहरूको लागि आदर्श बनाउँछ जहाँ अपेक्षाकृत छोटो समयमा बाक्लो अक्साइड तह आवश्यक हुन्छ। पानीको अणुहरूको उपस्थितिले छिटो अक्सिडेशनको लागि अनुमति दिन्छ किनकि H2O सँग अक्सीकरण प्रक्रियाहरूमा प्रयोग हुने अन्य ग्यासहरू भन्दा सानो आणविक द्रव्यमान हुन्छ।
यद्यपि, गीला ओक्सीकरण छिटो हुँदा, यसको सीमितताहरू छन्। भिजेको ओक्सीकरण द्वारा उत्पादित अक्साइड तहमा अन्य विधिहरूको तुलनामा कम एकरूपता र घनत्व हुन्छ। थप रूपमा, प्रक्रियाले हाइड्रोजन (H2) जस्ता उप-उत्पादनहरू उत्पन्न गर्दछ, जसले कहिलेकाहीँ अर्धचालक निर्माण प्रक्रियामा पछिका चरणहरूमा हस्तक्षेप गर्न सक्छ। यी कमजोरीहरूको बावजुद, भिजेको ओक्सीकरण बाक्लो अक्साइड तहहरू उत्पादन गर्नको लागि व्यापक रूपमा प्रयोग गरिएको विधि हो।
सुख्खा ओक्सीकरण
ड्राई अक्सिडेशनले उच्च-तापमान अक्सिजन (O2) को प्रयोग गर्दछ, प्राय: नाइट्रोजन (N2) सँग मिलाएर, अक्साइड तह बनाउन। H2O को तुलनामा O2 को उच्च आणविक द्रव्यमानको कारणले गर्दा यस प्रक्रियामा अक्सीकरणको दर भिजेको अक्सीकरणको तुलनामा ढिलो हुन्छ। यद्यपि, सुख्खा अक्सिडेशनद्वारा बनेको अक्साइड तह अधिक समान र घन हुन्छ, जसले यसलाई पातलो तर उच्च गुणस्तरको अक्साइड तह आवश्यक पर्ने अनुप्रयोगहरूको लागि उपयुक्त बनाउँछ।
ड्राई अक्सिडेशनको मुख्य फाइदा हाइड्रोजन जस्ता उप-उत्पादनहरूको अनुपस्थिति हो, सेमीकन्डक्टर निर्माणको अन्य चरणहरूमा हस्तक्षेप गर्ने सम्भावना कम हुने क्लिनर प्रक्रिया सुनिश्चित गर्दै। यो विधि विशेष गरी अक्साइडको मोटाई र गुणस्तरमा सटीक नियन्त्रण चाहिने उपकरणहरूमा प्रयोग हुने पातलो अक्साइड तहहरूका लागि उपयुक्त छ, जस्तै MOSFETs का लागि गेट अक्साइडहरूमा।
फ्री रेडिकल ऑक्सीकरण
फ्री रेडिकल अक्सिडेशन विधिले उच्च-तापमान अक्सिजन (O2) र हाइड्रोजन (H2) अणुहरूलाई अत्यधिक प्रतिक्रियाशील रासायनिक वातावरण सिर्जना गर्न प्रयोग गर्दछ। यो प्रक्रिया ढिलो ओक्सीकरण दरमा सञ्चालन हुन्छ, तर परिणामस्वरूप अक्साइड तहमा असाधारण एकरूपता र घनत्व हुन्छ। प्रक्रियामा संलग्न उच्च तापक्रमले फ्री रेडिकलहरूको गठन निम्त्याउँछ - अत्यधिक प्रतिक्रियाशील रासायनिक प्रजातिहरू - जसले अक्सिडेशनलाई सहज बनाउँछ।
फ्री रेडिकल अक्सिडेशनको प्रमुख फाइदाहरू मध्ये एक सिलिकन मात्र नभई अन्य सामग्रीहरू जस्तै सिलिकन नाइट्राइड (Si3N4) लाई पनि अक्सिडाइज गर्ने क्षमता हो, जुन प्राय: अर्धचालक उपकरणहरूमा अतिरिक्त सुरक्षात्मक तहको रूपमा प्रयोग गरिन्छ। फ्री रेडिकल अक्सिडेशन पनि अक्सिडाइजिङ (100) सिलिकन वेफर्समा अत्यधिक प्रभावकारी हुन्छ, जसमा अन्य प्रकारका सिलिकन वेफर्सको तुलनामा घना परमाणु व्यवस्था हुन्छ।
उच्च प्रतिक्रियाशीलता र नियन्त्रित अक्सीकरण अवस्थाहरूको संयोजन फ्री रेडिकल अक्सीकरणमा परिणाम एक अक्साइड तहमा हुन्छ जुन एकरूपता र घनत्व दुवैको सन्दर्भमा उच्च हुन्छ। यसले विशेष गरी उन्नत अर्धचालक यन्त्रहरूमा अत्यधिक भरपर्दो र टिकाउ अक्साइड तहहरू चाहिने अनुप्रयोगहरूको लागि उत्कृष्ट छनोट बनाउँछ।
Semicorex उच्च गुणस्तर प्रदान गर्दछSiC भागहरूप्रसार प्रक्रियाहरु को लागी। यदि तपाइँसँग कुनै सोधपुछ छ वा थप विवरणहरू चाहिन्छ भने, कृपया हामीलाई सम्पर्क गर्न नहिचकिचाउनुहोस्।
सम्पर्क फोन # +86-13567891907
इमेल: sales@semicorex.com




