
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
चिप निर्माणमा SiGe: एक व्यावसायिक समाचार रिपोर्ट
अर्धचालक सामग्रीको विकास
आधुनिक अर्धचालक टेक्नोलोजीको दायरामा, लघुकरणको लागि अथक ड्राइभले परम्परागत सिलिकन-आधारित सामग्रीहरूको सीमालाई धक्का दिएको छ। उच्च प्रदर्शन र कम बिजुली खपतको लागि मागहरू पूरा गर्न, SiGe (सिलिकन जर्मेनियम) यसको अद्वितीय भौतिक र विद्युतीय गुणहरूको कारण अर्धचालक चिप निर्माणमा छनौटको समग्र सामग्रीको रूपमा उभिएको छ। यो लेख मा delvesepitaxy प्रक्रियाSiGe को र epitaxial वृद्धि मा यसको भूमिका, तनावग्रस्त सिलिकन अनुप्रयोगहरू, र गेट-अल-अराउन्ड (GAA) संरचनाहरू।
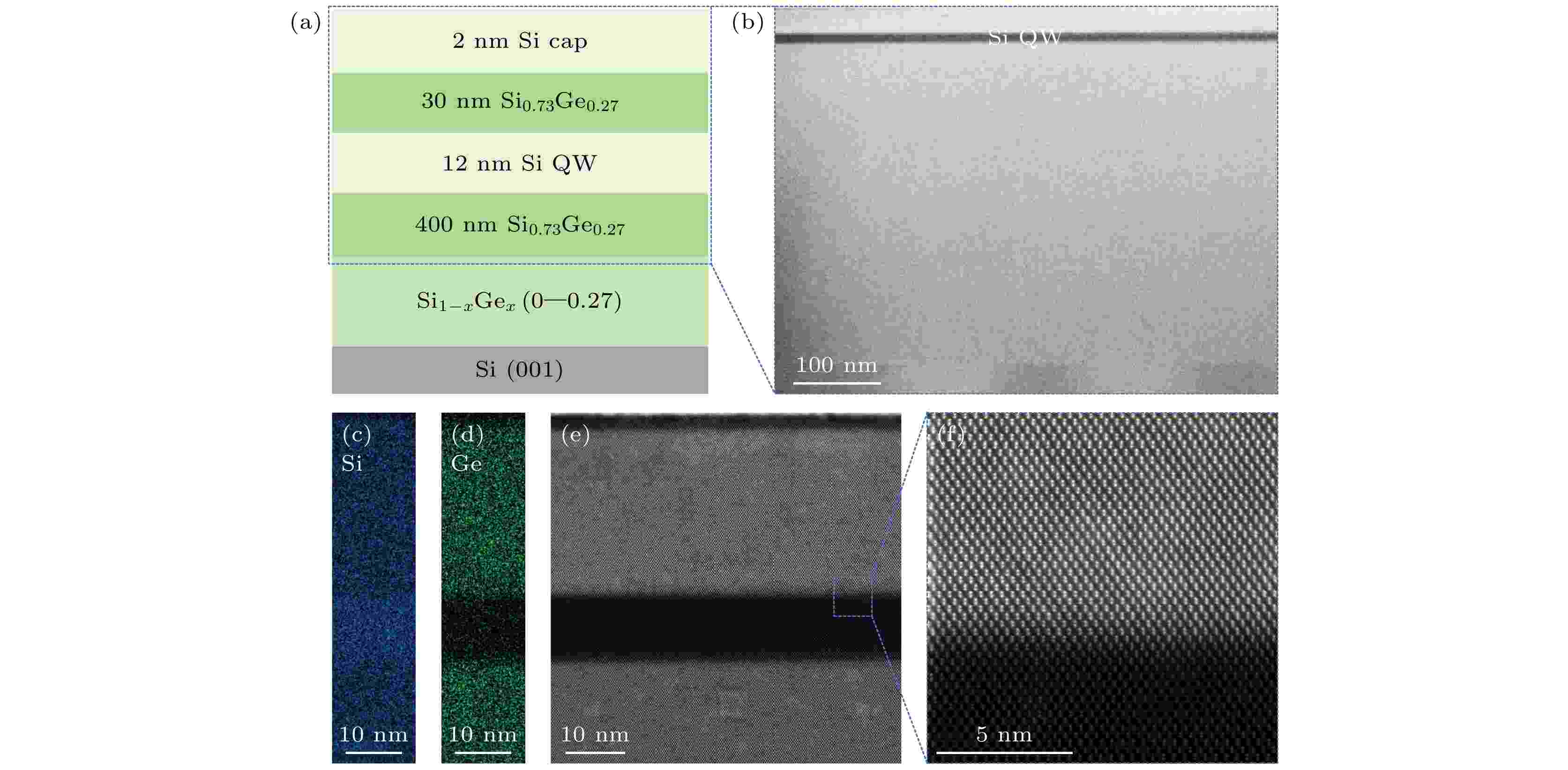
SiGe Epitaxy को महत्व
1.1 चिप निर्माणमा Epitaxy को परिचय:
Epitaxy, प्राय: Epi को रूपमा संक्षिप्त, समान जाली व्यवस्था संग एकल-क्रिस्टल सब्सट्रेट मा एकल-क्रिस्टल तहको वृद्धिलाई जनाउँछ। यो तह पनि हुन सक्छhomoepitaxial (जस्तै Si/Si)वा heteroepitaxial (जस्तै SiGe/Si वा SiC/Si)। epitaxial वृद्धिका लागि विभिन्न विधिहरू प्रयोग गरिन्छ, जसमा आणविक बीम एपिटेक्सी (MBE), अल्ट्रा-हाई भ्याकुम केमिकल भाप डिपोजिसन (UHV/CVD), वायुमण्डलीय र न्यून चाप एपिटेक्सी (ATM र RP Epi) समावेश छ। यस लेखले सिलिकन (Si) र सिलिकन-जर्मेनियम (SiGe) को एपिटाक्सी प्रक्रियाहरूमा फोकस गर्दछ जुन सिलिकनसँग सब्सट्रेट सामग्रीको रूपमा सेमीकन्डक्टर एकीकृत सर्किट उत्पादनमा व्यापक रूपमा प्रयोग गरिन्छ।
1.2 SiGe Epitaxy का फाइदाहरू:
को समयमा जर्मेनियम (Ge) को एक निश्चित अनुपात समावेश गर्दैepitaxy प्रक्रियाSiGe एकल-क्रिस्टल तह बनाउँछ जसले ब्यान्डग्याप चौडाइ मात्र घटाउँदैन तर ट्रान्जिस्टरको कट-अफ फ्रिक्वेन्सी (fT) पनि बढाउँछ। यसले यसलाई वायरलेस र अप्टिकल संचारको लागि उच्च-फ्रिक्वेन्सी उपकरणहरूमा व्यापक रूपमा लागू हुन्छ। यसबाहेक, उन्नत CMOS एकीकृत सर्किट प्रक्रियाहरूमा, Ge र Si बीचको जाली मिल्दोजुल्दो (लगभग 4%) ले जाली तनाव परिचय गराउँछ, इलेक्ट्रोन वा प्वालहरूको गतिशीलता बढाउँछ र यसरी उपकरणको संतृप्ति वर्तमान र प्रतिक्रिया गति बढाउँछ।
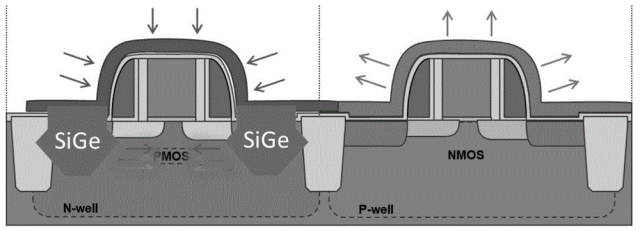
व्यापक SiGe Epitaxy प्रक्रिया प्रवाह
२.१ पूर्व उपचार:
सिलिकन वेफरहरू वांछित प्रक्रिया परिणामहरूको आधारमा पूर्व-उपचार गरिन्छ, मुख्य रूपमा प्राकृतिक अक्साइड तह र वेफर सतहमा अशुद्धता हटाउने समावेश गर्दछ। भारी डोप गरिएको सब्सट्रेट वेफर्सका लागि, पछिल्ला समयमा स्वत: डोपिङ कम गर्न ब्याकसीलिङ आवश्यक छ कि छैन भनेर विचार गर्न महत्त्वपूर्ण छ।epitaxy वृद्धि.
२.२ ग्रोथ ग्याँस र सर्तहरू:
सिलिकन ग्यासहरू: सिलेन (SiH₄), Dichlorosilane (DCS, SiH₂Cl₂), र Trichlorosilane (TCS, SiHCl₃) तीनवटा सबैभन्दा बढी प्रयोग हुने सिलिकन ग्यास स्रोत हुन्। SiH₄ कम-तापमान पूर्ण एपिटेक्सी प्रक्रियाहरूको लागि उपयुक्त छ, जबकि TCS, यसको तीव्र वृद्धि दरको लागि परिचित छ, व्यापक रूपमा मोटो तयारीको लागि प्रयोग गरिन्छ।सिलिकन एपिटेक्सीतहहरू।
जर्मेनियम ग्याँस: जर्मेनियम (GeH₄) जर्मेनियम थप्नको लागि प्राथमिक स्रोत हो, SiGe मिश्र धातुहरू बनाउन सिलिकन स्रोतहरूसँग संयोजनमा प्रयोग गरिन्छ।
चयनात्मक epitaxy: चयनात्मक वृद्धि को सापेक्ष दर समायोजन गरेर हासिल गरिन्छepitaxial बयानर सिटु इचिङमा, क्लोरीन युक्त सिलिकन ग्यास DCS प्रयोग गरी। चयनशीलता सिलिकन सतहमा Cl परमाणुहरूको शोषण अक्साइड वा नाइट्राइडमा भन्दा कम भएको कारणले हुन्छ, जसले एपिटेक्सियल वृद्धिलाई सहज बनाउँछ। SiH₄, Cl परमाणुहरूको अभाव र कम सक्रियता ऊर्जाको साथ, सामान्यतया केवल कम-तापमान पूर्ण एपिटेक्सी प्रक्रियाहरूमा लागू हुन्छ। अर्को सामान्य रूपमा प्रयोग हुने सिलिकन स्रोत, TCS, कम भापको चाप हुन्छ र कोठाको तापक्रममा तरल हुन्छ, यसलाई प्रतिक्रिया कक्षमा परिचय गराउन H₂ बबलिङ आवश्यक हुन्छ। जे होस्, यो अपेक्षाकृत सस्तो छ र प्राय: यसको द्रुत वृद्धि दर (5 μm/मिनेट सम्म) बाक्लो सिलिकन एपिटेक्सी तहहरू बढ्नको लागि प्रयोग गरिन्छ, सिलिकन एपिटेक्सी वेफर उत्पादनमा व्यापक रूपमा लागू हुन्छ।
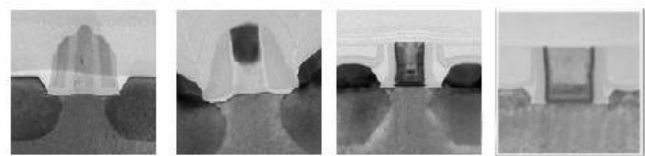
Epitaxial तहहरूमा तनावग्रस्त सिलिकन
समयमाepitaxial वृद्धि, एपिटेक्सियल एकल-क्रिस्टल Si एक आराम SiGe तहमा जम्मा गरिएको छ। Si र SiGe बीचको जाली बेमेलको कारण, Si एकल-क्रिस्टल तह अन्तर्निहित SiGe तहबाट तन्य तनावको अधीनमा छ, उल्लेखनीय रूपमा NMOS ट्रान्जिस्टरहरूमा इलेक्ट्रोन गतिशीलता बढाउँछ। यो प्रविधिले संतृप्ति करेन्ट (Idsat) मात्र बढाउँदैन तर उपकरणको प्रतिक्रिया गति पनि सुधार गर्छ। PMOS यन्त्रहरूका लागि, च्यानलमा कम्प्रेसिभ तनाव प्रस्तुत गर्न, प्वाल गतिशीलता बढाउन र संतृप्ति प्रवाह बढाउन नक्काशी पछि SiGe तहहरू स्रोत र नाली क्षेत्रहरूमा एपिटेक्सिली रूपमा बढाइन्छ।
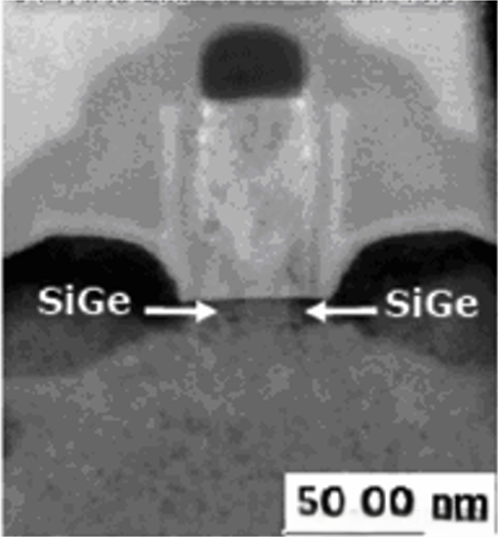
GAA संरचनाहरूमा बलिदान तहको रूपमा SiGe
गेट-अल-अराउन्ड (GAA) नानोवायर ट्रान्जिस्टरहरूको निर्माणमा, SiGe तहहरूले बलिदान तहहरूको रूपमा कार्य गर्दछ। उच्च-चयनात्मक एनिसोट्रोपिक नक्काशी प्रविधिहरू, जस्तै अर्ध-परमाणु तह नक्काशी (अर्ध-एएलई), नानोवायर वा न्यानोसिट संरचनाहरू बनाउन SiGe तहहरूलाई सटीक हटाउन अनुमति दिन्छ।
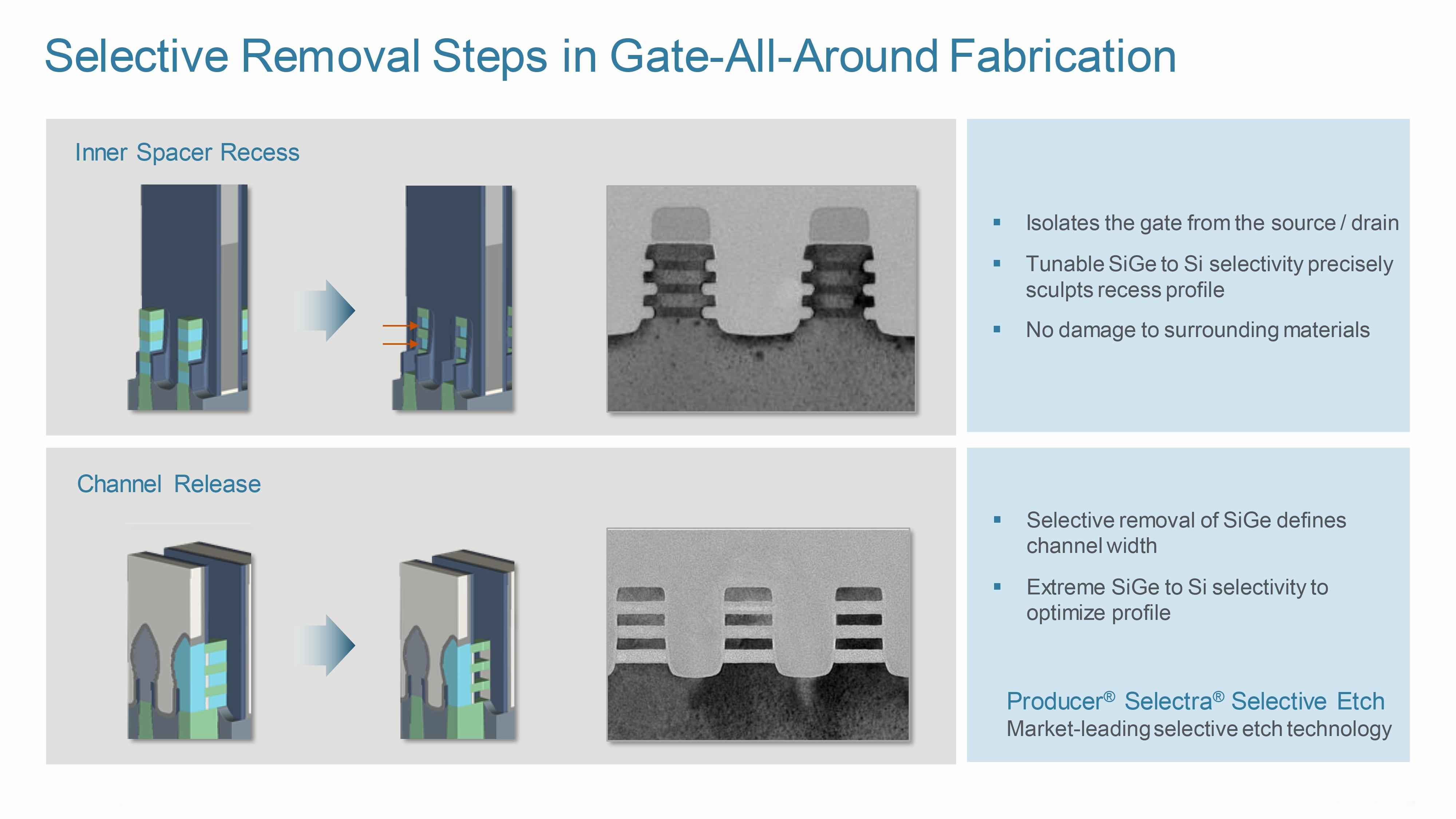
हामी Semicorex मा विशेषज्ञ छौंSiC/TaC लेपित ग्रेफाइट समाधानसेमीकन्डक्टर निर्माणमा Si epitaxial वृद्धिमा लागू गरिएको छ, यदि तपाइँसँग कुनै सोधपुछ छ वा थप विवरणहरू चाहिन्छ भने, कृपया हामीलाई सम्पर्क गर्न नहिचकिचाउनुहोस्।
सम्पर्क फोन: +86-13567891907
इमेल: sales@semicorex.com




