
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiGe र Si चयनात्मक नक्काशी प्रविधि
गेट-अल-अराउन्ड FET (GAAFET), FinFET लाई प्रतिस्थापन गर्न तयार भएको अर्को पुस्ताको ट्रान्जिस्टर आर्किटेक्चरको रूपमा, यसको उच्च इलेक्ट्रोस्ट्याटिक नियन्त्रण र साना आयामहरूमा परिष्कृत कार्यसम्पादन प्रदान गर्ने क्षमताको लागि महत्त्वपूर्ण ध्यान दिइएको छ। n-प्रकार GAAFETs को निर्माण मा एक महत्वपूर्ण कदम उच्च-चयनिता समावेश गर्दछ।नक्काशीSiGe को: Si स्ट्याकहरू भित्री स्पेसरहरू जम्मा गर्नु अघि, सिलिकन नानोसिटहरू उत्पन्न गर्दै र च्यानलहरू रिलिज गर्दै।

यो लेख चयनात्मक मा delvesनक्काशी प्रविधिहरूयस प्रक्रियामा संलग्न छ र दुई उपन्यास नक्काशी विधिहरू प्रस्तुत गर्दछ - उच्च अक्सिडेटिभ ग्यास प्लाज्मा-फ्री एचिंग र एटोमिक लेयर एचिंग (ALE) - जसले SiGe एचिंगमा उच्च परिशुद्धता र चयनशीलता प्राप्त गर्न नयाँ समाधानहरू प्रस्ताव गर्दछ।
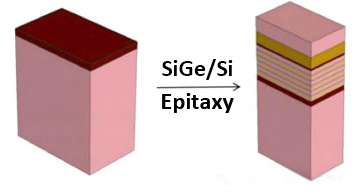
GAA संरचनाहरूमा SiGe Superlattice तहहरू
GAAFETs को डिजाइनमा, उपकरणको कार्यसम्पादन बढाउन, Si र SiGe को वैकल्पिक तहहरू छन्।सिलिकन सब्सट्रेटमा epitaxially हुर्काइन्छ, बहु-तह संरचना बनाउँछ जसलाई सुपरलेटिस भनिन्छ। यी SiGe तहहरूले वाहक एकाग्रता मात्र समायोजन गर्दैन तर तनावको परिचय दिएर इलेक्ट्रोन गतिशीलता पनि सुधार गर्दछ। यद्यपि, पछिल्ला प्रक्रियाका चरणहरूमा, यी SiGe तहहरूलाई सिलिकन तहहरू कायम राख्दा ठ्याक्कै हटाउन आवश्यक छ, उच्च चयनात्मक नक्काशी प्रविधिहरू चाहिन्छ।
SiGe को चयनात्मक नक्काशी लागि विधिहरू
उच्च अक्सिडेटिभ ग्यास प्लाज्मा-मुक्त नक्काशी
ClF3 ग्यासको छनोट: यो नक्काशी विधिले 1000-5000 को SiGe:Si चयनशीलता अनुपात हासिल गर्दै चरम चयनशीलता, जस्तै ClF3 सँग अत्यधिक अक्सिडेटिभ ग्यासहरू प्रयोग गर्दछ। यो प्लाज्मा क्षति बिना कोठा को तापमान मा पूरा गर्न सकिन्छ।
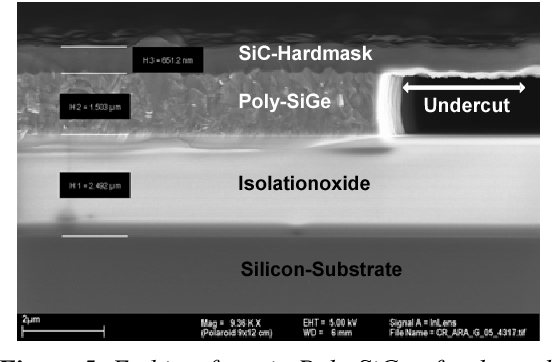
कम-तापमान दक्षता: इष्टतम तापमान 30 डिग्री सेल्सियसको वरिपरि छ, कम-तापमान परिस्थितिहरूमा उच्च-चयनात्मक नक़्किङलाई महसुस गर्दै, अतिरिक्त थर्मल बजेट वृद्धिलाई बेवास्ता गर्दै, जुन उपकरणको प्रदर्शन कायम राख्न महत्त्वपूर्ण छ।
सुख्खा वातावरण: सम्पूर्णनक्काशी प्रक्रियापूर्णतया सुख्खा अवस्थाहरूमा सञ्चालन गरिन्छ, संरचना आसंजनको जोखिमलाई हटाउँदै।
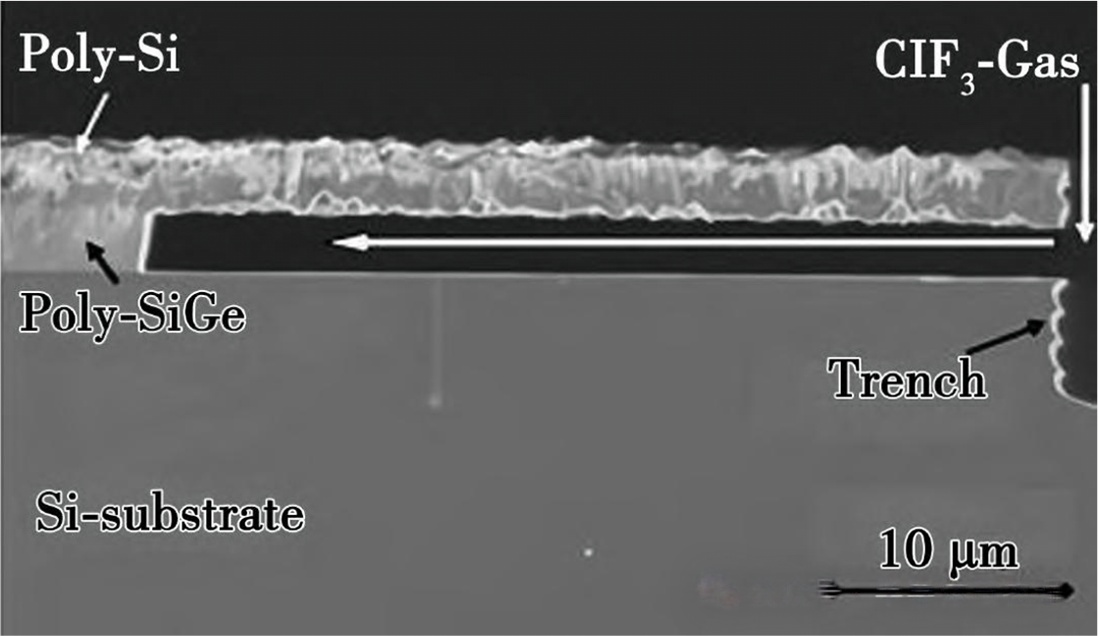
एटोमिक लेयर इचिङ (ALE)
आत्म-सीमित विशेषताहरू: ALE दुई-चरण चक्रीय होनक्काशी प्रविधि, जहाँ नक्काशी गरिने सामग्रीको सतह पहिले परिमार्जन गरिन्छ, र त्यसपछि परिमार्जित तहलाई अपरिवर्तित भागहरूलाई असर नगरी हटाइन्छ। प्रत्येक चरण आत्म-सीमित छ, एक पटकमा केही परमाणु तहहरू हटाउने स्तरको सटीकता सुनिश्चित गर्दै।
चक्रीय नक्काशी: माथि उल्लिखित दुई चरणहरू दोहोर्याइएको छ जबसम्म इच्छित नक्काशी गहिराइ प्राप्त हुँदैन। यो प्रक्रियाले ALE लाई प्राप्त गर्न सक्षम बनाउँछपरमाणु-स्तर परिशुद्धता नक्काशीभित्री पर्खालहरूमा सानो आकारको गुफाहरूमा।

हामी Semicorex मा विशेषज्ञ छौंSiC/TaC लेपित ग्रेफाइट समाधानसेमीकन्डक्टर निर्माणमा Etching प्रक्रियाहरूमा लागू, यदि तपाईंसँग कुनै सोधपुछ छ वा थप विवरणहरू चाहिन्छ भने, कृपया हामीलाई सम्पर्क गर्न नहिचकिचाउनुहोस्।
सम्पर्क फोन: +86-13567891907
इमेल: sales@semicorex.com




